
 EN
EN


采用倒装芯片球栅格阵列的封装形式,具有高密度I/O数以及高散热性。其产品主要特点为:多高层结构、大尺寸、超精细线路等级,增层多使用SAP工艺进行进行线路的制作。主要应用在CPU、GPU、FPGA、ASIC等高运算性能产品。
1. 高多层结构:1-2-1 ~ 10-2-10
2. Unit尺寸:21mm×21mm ~ 77.5mm×77.5mm
3. 精细线路:SAP工艺,9/12μm
4. 表面处理:ENEPIG+SOP / IT+SOP / OSP+SOP



数据中心、智能驾驶、人工智能、高性能计算(HPC)等领域
指的是系统级封装,这种封装将多种功能芯片或晶圆和被动元器件集成在一个封装内,从而实现一个基本完整的系统功能,以实现多功能、小尺寸、高性能、低成本的目标。
· 层数/layer amount: 2~8层/Layer
· 线宽公差:减成法:±10μm,改进半加成法:±5μm
· 表面处理:化学学镍钯金或电镀镍金,支持WB和FC封装
· 盲孔孔径/孔盘:60/100μm,
· 相邻层与任意层层间对位能力:25μm Max/50μm Max
· 支持孔上打线设计,塞孔凹陷-3~+5μm
消费电子、通信、计算机、工业自动化以及汽车电子等领域
保存程序和各种数据等的存储介质,半导体存储器占比最大的两类主要为DRAM以及NAND,其中DRAM细分产品包含DDR、LPDDR、GDDR,NAND细分产品包含eMMC、eMCP、UFS、uMCP、SSD及SD、MSD等卡类产品。
· 层数/layer amount: 2,3,4
· 超薄板: 2L 80μm, 3L 100μm, 4L 130μm
· 精细手指:pitch/width/space:70/40/15μm
· 油墨平整度SR Flatness:线路3μm, 孔5μm
· 盲孔孔径BLV/孔盘Land:60/105μm






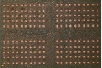
智能手机、智能平板、智能穿戴等消费电子、数据通讯、汽车电子、工业控制等领域
此类基板特征为Top面有呈阵列排列的焊料凸点(Bump pad),将晶片之正面翻覆(Flip)后,以凸块(Bumping)形式可直接与基板连接,信号传输路径短,晶粒背面外露,散热性能特别好;背面为球形触点阵列,背面带金属球,用于连接产品和PCB板,实现产品功能。
· 层数/layer amount: 2~8层/layer
· 线宽trace width/线距space:8/10μm(ETS) and 15/15μm(MSAP)
· 值球焊垫中心距/Bump pitch:130μm
· 典型表面处理/Typical Surface finish:OSP/ENEPIG
· 油墨对准度SM Registration:±12.5μm
· 支持阻抗设计/Support Impedance
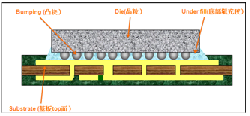





智能手机、智能平板、智能穿戴等消费电子、数据通讯、汽车电子、工业控制、医疗器械等领域
此类基板特征为Top面有用于打线的Bonding Finger设计,芯片通过银胶黏贴在基板的正面或背面,芯片与基板连通通过打线实现;Bot面设计有BGA PAD,封装产品的背面带金属球,用于连接产品和PCB板,实现产品功能。
· 层数/layer amount: 2~8层/layer
· 线宽trace width/线距space:25/25μm
· 手指finger width/手指间距finger space:90/40μm
· 严格的油墨平整度要求/ Strict SM flatness control ≤5μm
· 支持无引线电镀镍金设计/Support Bussless Design
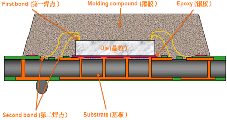
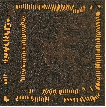


智能手机、智能平板、智能穿戴等消费电子、汽车电子、工业控制、医疗器械等领域
微机电系统中的一大类,包括麦克风和耳机产品,主要设计有埋容、埋阻、空腔、凸台等,尺寸大多介于1.5X1.5mm ~ 5X5mm之间。
· 层数/layer amount: 2,4,6
· 埋电容材料电容密度/nEmbeded capacitance density Max.40nf/in2:
· 容值精度/Capacitor value tolerance: Target±20%
· 埋电阻材料方阻率/Rs for Embeded resistance material:10~250 Ω/□
· 基板阻值精度/Resistor value tolerance: Target±20%
· 结构多样,支持树脂塞孔和铜塞孔/ Multiple structure, support resin and copper plugging
· 声孔孔径公差/ Port Hole Dia Tolerance (NPTH):±50μm


智能手机、智能平板、智能穿戴等消费电子、汽车电子等领域